1-7 Expose(3)_해상도 개선 기술
CMP, 단파장, immersion(액침노광), PSM, OPC
저번 글에서 Trade-off관계에 있는 Resoluton, DOF에 대해 공부했습니다.
이번에는 이러한 해상도를 개선하는 기술들을 공부해 보겠습니다.
Resolution = k1*(파장/NA), DOF = k2*(파장/NA^2)
Resolution은 작을수록 좋고, DOF는 클수록 좋으므로 이 공식 관점에서 살펴보겠습니다.
CMP
CMP는 반도체 8대공정 중 하나입니다. Chemical Mechanical Polishing의 약자로 wafer위 울퉁불퉁한 표면을 평평하게 해주는 기술입니다. 이게 왜 Expose에 나왔을까요? DOF와 관련이 있기 때문입니다.
DOF는 wafer의 수직방향으로의 해상도를 의미합니다. 만약 PR표면이 울퉁불퉁 단차가 심해 높은 곳과 낮은 곳이 있다면 DOF의 여유도가 매우 커야 합니다. 따라서 높이차이를 최대한 줄여 상대적으로 작은 DOF에도 빛이 잘 조사될 수 있게 해주는 게 CMP 공정입니다. 즉 DOF를 크게 하는 게 아닌 같은 DOF라도 wafer표면 높이차이를 줄여주어 원활한 공정이 진행될 수 있게 해주는 공정입니다.
단파장
Photolithography에 사용되는 광원, 즉 빛의 파장을 줄여 해상도를 개선하는 방법입니다.
1980년대부터 지금까지 사용되왔던 광원과 파장을 알아보겠습니다.
g-line(436nm) - i-line(356nm) - KrF(248nm) - ArF(193nm) - EUV(13.5nm)
g-line(436nm)과 i-line(356nm)은 1980대부터 사용한 광원이고 수은램프(UV : 자외선)를 사용합니다.
KrF(248nm)와 ArF(193nm)는 엑시머 레이져(Excimer Laser)에 의한 원자외선(DUV : Deep UV)을 사용합니다.
위 빛은 어떻게 만들어 질까요? 엑시머에 순간적으로 많은 에너지를 가해 여기된 상태를 만듭니다. 여기된 엑시머는 안정된 상태로 돌아가려 하고 이 과정에서 받은 에너지를 빛으로 방출하며 원래 상태로 돌아옵니다. 이 과정에서 특정 파장의 빛이 방출되는 원리입니다.
정리하자면 짧은 파장의 빛을 사용해 Resolution을 작게 만들어 개선시킬 수 있습니다.
Immersion(액침노광)
액침노광은 ArF(193nm)장비에 사용됩니다. 보통 NA = n*sin세타 공식에서 n값을 늘리는 기술입니다.

저번에 사용한 그림을 다시 가져와 봤습니다. 보통은 렌즈와 wafer사이는 진공으로 이루어져 있어 n(굴절률)은 1입니다. 여기서 렌즈와 wafer사이에 초순수를 넣어 굴절률을 n=1.44까지 올리는 기술입니다.
*초순수 : 이온, 유기물, 균 등을 모두 제거한 물.
그럼 여기서 n이 1에서 1.44로 증가하니까 NA가 증가해 R이 줄어 Resolution이 짧아질까요? 그렇지 않습니다.
왜 그렇지 않은지 잠시 스넬의 법칙을 공부하고 오겠습니다.
매질의 종류에 따라 n(굴절률)은 바뀌게 됩니다. 위 그림은 굴절률이 n1, n2로 다른 매질을 빛이 통과하는 이미지 입니다.
스넬의 법칙(snell's law) : n1*sin세타1 = n2*sin세타2
위와 같이 두 개의 곱은 같습니다.
다시 초순수를 넣어 n이 1에서 1.44로 증가한 immersion장비로 돌아오겠습니다. n이 1에서 1.44로 증가하더라도 NA = n*sin세타 로 결국 스넬의 법칙에 의해 NA값은 같습니다. n이 1.44로 증가해도 각도가 줄어 NA는 같게 유지됩니다.
그럼 왜 Immersion장비를 쓸까요?
(1) DOF 여유도 개선
(2) 큰 렌즈의 사용 가능
DOF여유도가 개선이 되는 이유는 위에서 스넬의 법칙에서 봤을 때에도 n이 증가해 세타가 줄었습니다. 각도가 준다는 뜻은 DOF여유도가 증가된다는 의미입니다.
*이 부분에 대한 설명은 바로 이 전 글인 1-6 Expose(2)에 기록해 두었습니다.
두 번째로 Immersion장비는 왜 큰 렌즈의 사용이 가능할까요?
원래 큰 렌즈를 사용하기 힘들었던 게 NA가 커지기 때문에 DOF가 급격히 감소했기 때문입니다. (1)에서 DOF 여유도를 개선해 줬기 때문에 렌즈의 크기를 키울 수 있는 여유가 생기게 되었습니다.
또한 렌즈의 굴절률은 약 1.6이고 물의 굴절률은 1.44이므로 기존 공기보다 굴절률 차이가 적어 렌즈와 매질(물) 사이 임계각이 더 커지게 되었습니다. 이로 인해 더 큰 렌즈를 사용하게 될 수 있습니다.
*이 부분 좀 어려우니 pass 하셔도 됩니다.
액침노광의 문제점
(1) 물과 PR의 접촉으로 인해 PR이 용해되어 렌즈 및 패턴 오염.
(2) 물방울이 생길 경우 빛의 경로에 문제가 생겨 패턴에 불량 발생.
지금까지는 NA와 파장 관점에서 보았습니다. 앞으로는 공정상수 k에 해당하는 노광공정 기술에 대해 알아보겠습니다.
OAI(Off Axis Illumination)
비등축조명노광

*차광 개념은 이 전 글인 1-6 Expose(2)에 기록해 두었습니다.
마스크를 통과한 회절 된 빛이 가능한 많은 차광이 렌즈로 들어야 한다는 것을 배웠습니다. 그래야 해상도가 선명하게 나옵니다. 만약 왼쪽 그림처럼 +-1차광이 렌즈로 투영되지 못하는 문제가 있다면 광축을 경사지게 입사시켜 최소 0차광과 -1차광이라도 입사시키는 방법이 OAI입니다. 빛을 경사지게 입사시켜 더 많은 차광이 들어오므로 렌즈를 크기를 키우는 것과 마찬가지인 효과이므로 NA값이 증가합니다. 또한 wafer로 입사되는 입사각이 작아져 DOF여유도도 개선됩니다. Resolution와 DOF는 Trade-OFF관계임을 1-6 Expose(2)에서 공부했지만 이는 둘 모두를 개선시키는 방법입니다.
빛을 경사지게 입사시키는 방법은 원형 조명 조리개를 4공 조리개(Quadruple)로 교체하여 빛을 경사지게 할 수 있습니다.
PSM(Phase Shift Mask)
위상반전마스크
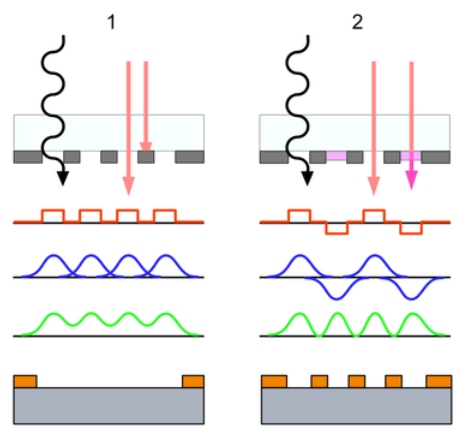
위에 1번 그림을 보면 빛의 보강간섭을 하는 부분이 겹쳐져 빛을 받으면 안 되는 부분까지 노광되는 문제를 볼 수 있습니다. 이를 해결하고자 2번 그림과 같이 Mask 틈 중간중간에 빛의 위상을 180도 반전시켜 버립니다. 이로인해 패턴의 경계부에서 상쇄간섭이 일어나 노광을 하고자 하는 부분만 정확히 노광 되어 해상도를 향상시키는 기술입니다.
OPC(Optical Proximity Correction)
광근접보정
예를들어 위와 같이 ㄴ모양의 패턴을 새긴다고 가정해 보겠습니다. 왼쪽 파란색 ㄴ모양은 빛을 노광한 결과 끝쪽에 노광이 덜 된 모습을 볼 수 있습니다. 이 모습을 보고 다음 노광시 ㄴ모양 끝쪽에 보강패턴을 초록색ㄴ과 같이 추가하여 노광하는 방식입니다. 즉 왜곡이 일어날 것으로 예상되는 부분을 미리 보정하는 기법을 OPC라고 합니다.
여기까지 Expose가 끝이 났습니다. 다음에는 Expose다음 공정인 PEB에 대해 알아보겠습니다.
'반도체 8대공정 > photolithography' 카테고리의 다른 글
| 1-9 photolithography(포토리소그래피) 공정_Develop(현상), Hard Bake, ADI, Rework (0) | 2021.01.04 |
|---|---|
| 1-8 photolithography(포토리소그래피) 공정_PEB (0) | 2021.01.03 |
| 1-6 Expose(2)_NA, DOF, Resolution (0) | 2021.01.01 |
| 1-5 photolithography(포토리소그래피) 공정_Expose(1) (0) | 2020.12.31 |
| 1-4 photolithography(포토리소그래피) 공정_Soft Bake (0) | 2020.12.30 |





댓글